Diskussion:Sputtern
Messung der Sputterrate?[Quelltext bearbeiten]
Wie bekommt man einen Wert für die Rate bei der Beschichtung/Sputterdeposition? Sollte dazu im Artikel nicht auch etwas stehen? (nicht signierter Beitrag von unsigned (Diskussion | Beiträge) 12:27, 25. Jun. 2015 (CET))
Überarbeitung[Quelltext bearbeiten]
Besteht Bedarf, die einzelnen Varianten, d.h. reaktiv-nichtreaktiv, balanced-unbalanced, DC-pulsed DC- AC-RF, HPPMS, Ionenstrahl und Doppel-Ionenstrahl, zu erwähnen/erläutern? (nicht signierter Beitrag von Olka (Diskussion | Beiträge) 18:03, 1. Feb. 2005 (CET))
Man sollte vieleicht erstmal erklären was Sputtern ist ((Schneideverfahren zur Herstellung von dünnen Halbleiterscheiben). Ich bintechnisch auf dem Gebiet nicht so sehr involviert. --Alma 19:48, 1. Feb 2006 (CET)
@ Alma "Schneideverfahren zur Herstellung von dünnen Halbleiterscheiben" das ist nicht richtig. Ich finde den Arikel eigentlich ganz in Ordnung, denn er zeigt die Verschiedenen Anwendungsmöglichkeiten des Sputtern auf und wie man auch lesen kann, ist Sputtern Kathodenzerstäubung, also der Beschuss einer Oberfläche mit Ionen. Natürlich kann man mit Sputtern auch schneiden, aber ebenso analysieren und beschichten.Benutzer:Do_ut_des 26.2.2006 (falsch signierter Beitrag von 84.56.20.10 (Diskussion) 17:17, 26. Feb. 2006 (CET))
Mit Zeit könnte man sicher viel ergänzen. Ich habe den Bericht zur Magnetronzerstäunbung mal mit verlinkt und an den entsprechenden Stellen auf DC und reaktives Sputtern hingewiesen. --OZ 11:57, 8. Feb 2006 (CET)
- Also der Artikel genügt meiner Meinung nach nicht den Qualitätskriterien der Wikipedia. Aus diesem Grund sollte er überarbeitet werden. Dazu gehört vor allem die Gliederung des Artikels. Im Artikel sollten dann die Grundlagen des Verfahrens, Varianten, Schichteigenschaften (auch in Bezug auf ein paar markante Prozessparameter (Druck, Temperatur) und natürlich Anwendungsbereiche behandelt werden. --Cepheiden 18:16, 26. Feb 2006 (CET)
"Beim Beschuss einer Oberfläche mit Ionen können, abhängig von den verwendeten Ionen und ihrer kinetischen Energie, verschiedene Effekte auftreten" - Effekte nicht nur abhängig von Energie und Ionenart, sondern auch vom Material der Oberfläche, Ladung der Ionen und auch dem Einfallswinkel - das ist mir aufgefallen da ich grad meine Mikrosystemtechnik Vorlesung durcharbeite --Brainer Sep 2006 (falsch signierter Beitrag von Brainer (Diskussion | Beiträge) 23:45, 26. Sep. 2006 (CEST))
- Ja und? Weiterbringen tut einen das jetzt aber nicht wirklich. --Cepheiden 01:02, 27. Sep 2006 (CEST)
Die Formel für die Anzahl gesputterter Teilchen kann so nicht richtig sein. Die Anzahl sollte doch von 0 bis Nmax mit t ansteigen. Hier müsste meiner Meinung nach (1-exp()) stehen. 6.12.06 (falsch signierter Beitrag von 153.96.116.2 (Diskussion) 16:40, 6. Dez. 2006 (CET))
- Zu den Grundlagen: Laut Artikel kondensieren die aus dem Target herausgelösten Teilchen auf dem Substrat, ist das tatsächlich richtig? Denn dann würde sich ja eine flüssige Schicht bilden die dann erstarrt. Ist es nicht vielmehr so, dass die Teilchen direkt aus dem gasförmigen in den festen Zustand übergehen? (nicht signierter Beitrag von 82.83.36.255 (Diskussion) 15:47, 14. Mär. 2007 (CET))
- Nunja, dass ist so'n bisschen Haarspalterei. Wodurch legt man bei Atomen die noch eine Oberflächenbeweglichkeit besitzen fest ob diese flüssig oder fest sind? Im Prinzip hast du aber schon recht, man könnte es auch als Desublimation statt Kondensation bezeichnen. Falsch ist der Begriff Kondensation hier jedenfalls nicht. Denn Sublimation ist ein Spezialfall der Kondensation (Änderung des Aggregatzustands eines Stoffes von gasförmig in flüssig oder fest [Römpp]). --Cepheiden 18:02, 14. Mär. 2007 (CET)
- Ich würde es als Desublimation bezeichnen, denn Der Widerstand abgeschiedener Metalle spricht gegen eine flüssige Phase auf der Oberfläche denn gesputterte Metalle haben einen recht hohen Flächenwiderstand der erst durch Thermische Behandlung gesenkt wird, wären die Stoffe (wenn auch kurzzeitig) flüssig, würden sich meiner Meinung nach nicht so hohe Widerstände ergeben, aber wie bereits gesagt ist das irgendwie Haarspalterei. In den meisten Fachbüchern wird auch nur von "Anlagerung" gesprochen, ich denke bei Einzelnen Atomen kann man nicht von Agregatzuständen sprechen, denn die beschreiben sozusagen die Beweglichkeit der Atome untereinander was bei einem einzelnen Atom ja nicht geht --Cyberhofi (falsch signierter Beitrag von Cyberhofi (Diskussion | Beiträge) 11:23, 30. Mär. 2007 (CEST))
- Was meinst du mit "recht hohen Flächenwiderstand"? Von eine konkreten flüssigen Phase wurde doch hier auch garnicht gesprochen. Anlagerunf und Kondensation ist in meinen Augen korrekt, auch wenn in vielen Fällen auch Desublimation zutrifft. --Cepheiden 14:23, 30. Mär. 2007 (CEST)
- Naja eine gesputterte Schicht (beispielsweise Aluminium) hat einen recht hohen elektrischen Widerstand (bei Dünnen schichten als Flächenwiderstand gemessen) der erst durch weitere Thermische behandlung herabgesetzt wird, deshalb würde ich zur Desublimation tendieren, da eine Flüssigkeit beim erstarren ja regelmäßigere Strukturen erzeugen würde als einzelne Feststoffteilchen, aber wie gesagt es ist Haarspalterei man könnte auch behaupten das die Teilchen garnicht Kondensieren und sich einfach nur duch kohäsion mit bereits angelagerten Teilchen, bzw. Adhäsion mit dem Substrat halten, denn wer sagt das sie gasförmig sind? Der Aggregatzustand einzelner Atome im freien Raum ist in dem Sinne ja nicht zu bestimmen und unter den Druck und Temperaturverhältnissen die beim Sputtern herrschen müsste man genaugenommen sowieso von Feststoffen sprechen. --Cyberhofi (falsch signierter Beitrag von Cyberhofi (Diskussion | Beiträge) 23:56, 12. Apr. 2007 (CEST))
- Natürlich ist der Aggregatzustand einzelner Atome im "freien Raum" zu bestimmen. Der Stoff ist dann gasförmig, ab einer geringen Prozentzahl ionisierter Atome spricht man von einem Plasma. Ich gebe aber zu dass diese Formulierung etwas irreführend -und sinnlos- ist wenn man nur ein einzelnes Teilchen betrachtet. Gesetze wie das "ideale Gasgesetz" oder so etwas sind dann natürlich nicht anzuwenden, weil sie statistischen Charakter haben (Druck usw.).
- Naja eine gesputterte Schicht (beispielsweise Aluminium) hat einen recht hohen elektrischen Widerstand (bei Dünnen schichten als Flächenwiderstand gemessen) der erst durch weitere Thermische behandlung herabgesetzt wird, deshalb würde ich zur Desublimation tendieren, da eine Flüssigkeit beim erstarren ja regelmäßigere Strukturen erzeugen würde als einzelne Feststoffteilchen, aber wie gesagt es ist Haarspalterei man könnte auch behaupten das die Teilchen garnicht Kondensieren und sich einfach nur duch kohäsion mit bereits angelagerten Teilchen, bzw. Adhäsion mit dem Substrat halten, denn wer sagt das sie gasförmig sind? Der Aggregatzustand einzelner Atome im freien Raum ist in dem Sinne ja nicht zu bestimmen und unter den Druck und Temperaturverhältnissen die beim Sputtern herrschen müsste man genaugenommen sowieso von Feststoffen sprechen. --Cyberhofi (falsch signierter Beitrag von Cyberhofi (Diskussion | Beiträge) 23:56, 12. Apr. 2007 (CEST))
Ich möchte noch hinzufügen dass man in der wissenschaftlichen Beschreibung von "Migration" (dem Umherwandern des Teilchens auf der Substratoberfläche) und dann oft "Kondensieren" oder einfach Anlagern spricht. Wie schon richtig erwähnt wurde, wird der Begriff "kondensiert" oft nicht nur als Übergang von flüssig zu fest verwendet. Man denke an: Festkörperphysik = Physik der kondensierten Materie. (Schliesst natürlich auch desublimierte Materialien ein). @cyberhofi Die Behauptung das Flüssigkeiten beim Erstarren (immer) eine regelmäßigere Struktur erzeugen als einzelne Feststoffteilchen ist falsch. Denken Sie an Schmelzen (also amorphe Materialien wie Glas), und im Gegensatz dazu gesputterte Filme, mit hohen Migrationszeiten, wo sich die Teilchen (z.B. je nach Substrattemperatur) in verschiedenen Kristallstrukturen anordnen. Je nach Gitterabweichung zum Substrat kann dann ein fast fehlerfreier Kristall entstehen.
Ich beschäftige mich gerade etwas mit dem Sputtern von Legierungen: Im Text steht die Behauptung, dass ein Vorteil der Sputterdeposition ist, dass keine Entmischung von Legierungen auftritt, was so auch in der Quelle "Vorlesungsskript Dünnschichttechnik" nachzulesen ist. Nach etwas Recherche zu dem Thema habe ich allerdings mehrere Paper gefunden, in denen von verschiedenen Sputterraten für die einzelnen Elemente berichtet wird. Die Schichtzusammensetzung stimmt dadurch nicht mit derjenigen des Targets überein. Andererseits gibt es auch vereinzelte Veröffentlichungen, bei denen das Target doch gleichmäßig abgetragen wurde. Ich kenne mich mit dem Sputterprozess nicht gut genug aus, jedoch scheint die Behauptung, dass keine Entmischung auftritt, nur in Ausnahmefällen oder unter bestimmten Bedingungen zuzutreffen. Wegen mangelndem Fachwissen ändere ich den Artikel vorerst nicht, aber vielleicht gibt es ja einen Experten hier, der mehr zu dem Thema sagen kann? -- Rumo85 14:45, 27. Jan. 2011 (CET)
Zur Entmischung: Sputtern entmischt durch zwei Effekte: 1) unterschiedliche Sputterraten der Mikrokristalle verschiedener Phasen der Legierungskomponenten, besonders bei zB pulvermetallurgisch hergestellten Targets wie Ti-W, 2) unterschiedliche ballistische Streuung am Sputtergas in der Kammer, besonders bei hohen Drücken (viele Stöße vor der Kondensation) und stark unterschiedlichen Atomgewichten der Komponenten, wie etwa bei Ti-W. Tangens mittlerer Streuwinkel = m(gas)/m(metall) 1) ist durch die Targetherstellung beeinflußbar, 2) durch Wahl von Sputtergas und Druck (bzw eigentlich mittlerer freier Weglänge). In der Produktion ist oft 2) kaum veränderbar, da der Druck auch andere Schichteigenschaften wie zB Stress beeinflußt. Dann gleicht man den Streuverlust der leichteren Komponente schon im Voraus durch geeignete Zusammensetzung des Targets aus. Beispiel aus der Praxis: 15gewichts% Ti im Target, 12% im gesputterten TIW-Film. Und die Formel für N(t) ist zumindest irreführend beschrieben: sie beschreibt den Abtrag einer monoatomaren Schicht von Nmax Atomen auf einem Untergrund mit Y=0. Das ist für die Praxis eher irrelevant ;-) Praktisch ist n(t) = YIp/e , N(t) also = t*YIp/e . Das ist trivial und eigentlich nichts Anderes als die Definition des Sputteryields als Atome raus / Ionen rein. Nmax steckt als kristallografische Konstante schon in Y - siehe Entmischung. Das Schichtwachstum auf dem Substrat ist dann, solange noch kein kontinuierlicher Film existiert, viel interessanter. Thema für eine eigene Vorlesung ;-) (nicht signierter Beitrag von 91.2.253.236 (Diskussion) 11:41, 25. Feb. 2011 (CET))
Bild[Quelltext bearbeiten]
Das Bild ist etwas unpassend bzw. teilweise irreführend, der Begriff "Sputtering Gas" macht den eindruck als würde ein Spezielles gas was geputtert (abgeschieden) wird eingeleitet. Ich würd es eher Prozessgas oder ähnlich nennen weil es ja nur "Werkzeug" ist Außerdem ist auf dem Bild das Target unten, bei allen Anlagen die ich bisher gesehen habe ist das Target oben, obwohl das für die Funktion nicht zwangsläufig notwendig ist, ist es doch einfavch eine Tatsache. Die Einkopplung der Hochfrequenz wäre auch noch interessant, die ist ja auch unterschiedlich. Der Hinweis auf Ionenätzen (auch Sputterätzen) fehlt auch (oder ich hab ihn übersehen) Cyberhofi (falsch signierter Beitrag von Cyberhofi (Diskussion | Beiträge) 17:35, 6. Feb. 2007 (CET))
Wie du siehst ist das aus der englischen Wikipedia. Ich mag das Bild auch nicht und wollte eignetlich bald mal ein passendes Bild erstellen. Die Darstellung ist eh nicht ganz richtig. Es macht fast den Eindruck als wenn das "sputteriing gas" aus Argonionen besteht und schräg auf das Target beschleunigt werden. Wie gesagt mir gefällt die Darstellung nicht --Cepheiden 20:08, 6. Feb. 2007 (CET)
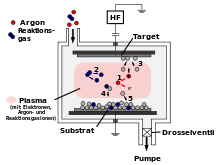
So ich hab mal fix eine eigene Grafik erstellt. So richtig gefällt sie mir noch nicht. Aber ich wollte mal hören, was ihr dazu sagt. --Cepheiden 10:43, 8. Feb. 2007 (CET)
Sieht ein bisschen überfüllt aus würd ich sagen, die "Atome" des Prozessgases (Argon und Reaktionsgas) würd ich weglassen und mich nur auf die Ionen beschränken, ein Pfeil rin mit "Prozessgase" und einer raus mit "Absaugung" oder "Vakuum" würde reichen denk ich. --Cyberhofi (falsch signierter Beitrag von Cyberhofi (Diskussion | Beiträge) 15:38, 8. Feb. 2007 (CET))
- Ja, stimmt. Ich hab mal die Version kurz überarbeiten und jetzt mehr wert auf mögliche Einzelreaktionen gelegt, die dann im Text erklärt werden können (1-5). --Cepheiden 09:47, 9. Feb. 2007 (CET)
- Nur ein kleiner, unwichtigerer Kommentar zum Target. Bei uns (Versuchsanlagen) ist die Kathode mit dem Target immer unten, das zu besputternde Substrat wird von oben genähert. Aber wie (Cyberhofi) bereits erwähnte ist das für den Prozess unerheblich.--Hbote 10:40, 6. Jan. 2011 (CET)
- Das Bild ist ja inzwischen verbessert worden. Was noch stört, ist das Reaktionsgas, das scheinbar immer mit einströmen soll. Es ist ja für den Sputterprozess nicht zwingend erforderlich und wird nur genutzt, um chemische Reaktionen mit den Targetatomen einzugehen, um z. B. Oxyde oder Nitrit zu generieren. Man könnte es einklammern oder mit "optional" versehen. --Cabfdb 07:54, 19. Jul. 2011 (CEST)
- Deswegen steht ja in der Bildbeschreibung der Zusatz "(reaktive HF-Sputterdeposition)". Das Bild erhebt nicht den Anspruch alle Formen oder die Grundform des Sputterprozesses zu beschreiben. --Cepheiden 15:43, 19. Jul. 2011 (CEST)
Effekte[Quelltext bearbeiten]
- Die Ionen werden in das Targetmaterial eingebaut und gehen dort gegebenenfalls eine chemische Verbindung ein. Dieser Effekt wird dann (reaktive) Ionenimplantation genannt.
Also mit Ionenimplantation hat das recht wenig zu tun, wär ja schön wenns so einfach wäre... Also ich würde den Satz am liebsten rausnehmen, mir ist dieser Effekt in diesem Ausmaß nicht bekannt, klar kann es sein das sich da mal einIon "verirrt" aber das gleich Ionenimplantation zu nennen... (nicht signierter Beitrag von Cyberhofi (Diskussion | Beiträge) 20:00, 15. Feb. 2007 (CET))
Anwendungen[Quelltext bearbeiten]
Könnte mal jemand vom Fach dem Rest von uns erklären, wofür dieses Verfahren eigentlich angewandt wird? Ein separater Anwendungs-Teil wäre nett, am besten mit Verweis auf Alltagsgegenstände: "In solcher Weise beschichtete Materialien findet man zum Beispiel im Auto(?), bei Solarzellen(?), ...". Danke!
-- mauriceKA 16:35, 27. Mär. 2009 (CET)
- Ich habe mal einen Anfang gemacht, so dass hier nach und nach aus den zahlreichen Anwendungsfeldern auch konkrete Beipiele folgen. --Cepheiden 20:36, 27. Mär. 2009 (CET)
Sputtern und Ausheizen[Quelltext bearbeiten]
„Bei zu langem Sputtern besteht zusätzlich die Gefahr, dass die noch nicht abgetragenen Schmutzatome in die Oberfläche gepresst werden. Deswegen sollte man abwechselnd Sputtern und Ausheizen (engl.: annealing]], anschmelzen, sodass sich die leichten Schmutzatome wieder an der Oberfläche ablagern).“
Hallo, der Absatz hier macht für mich wenig Sinn. Meiner Meinung nach bezieht er sich auf das Reinigungs-Sputtern. Aber warum sollte man Schmutzatome wieder an die Oberfläche binden wollen? Und wenn man hier "Annealing" mit "Anschmelzen" gleichsetzt trägt, dies sicher nicht zu einer besseren Erklärung bei. Wenn keien Gegenmeinungen oder Verbesserungen kommen, lösche ich den Satz (Zumal er unkommentiert von einem IP-Nutzer eingetragen wurde [[1]]) --Cepheiden 09:04, 1. Okt. 2009 (CEST) P.S. Ich hoffe ich irre mich, ansonsten frag ich mich warum sowas eigentlich als gesichtet markiert wird.
Ich habe das erstmal entfernt. Wenn es richtig war, kann man es ja wieder einfügen. --Cepheiden 09:46, 1. Okt. 2009 (CEST)
- Zumindest wird das Annealen dazu benutzt Kristallfehler zu beseitigen, da durch die zusätzliche thermische Energie eine Kristallfehlerumordnung geschehen kann (unabhängig von Schmutzatomen).--Hbote 10:43, 6. Jan. 2011 (CET)
- Ja, das es genutzt wird, ist doch gar nicht strittig. Eine Nutzung zu Rekristallisation wird auch gar nicht erwähnt. Strittig ist die Nutzung zur "Schichtreinigung". --Cepheiden 11:18, 6. Jan. 2011 (CET)
- mit ein paar kleinen Änderungen wird der Absatz ganz oben richtig:
- ersten Satz streichen. Blödsinn. Einzelne Atome ins Kristallgitter pressen ;-) Redeposition zB von Oxiden aus den Wänden eines Kontaktlochs ist etwas völlig anderes und passiert eher bei zu hoher Ar+ - Energie. + "nicht" zwischen Schmutzatome und wieder - annealing/anschmelzen einfach streichen.
Meist fängt man ja mit dem Ausheizen an, um die leicht flüchtigen Sachen an der Oberfläche (zB adsorbiertes Wasser) schon mal der Vakuumpumpe zu übergeben. (nicht signierter Beitrag von 91.2.248.62 (Diskussion) 19:40, 28. Feb. 2011 (CET))
Anfangsbeschreibung[Quelltext bearbeiten]
Hallo, meiner Meinung nach sollte man die Einführung etwas ändern: "...bei dem Atome aus einem Festkörper [...] herausgelöst werden". Durch diese Formulierung entsteht der Eindruck einzelne Atome würden durch die Ionen herausgelöst. Ein wichtiger Effekt den unsere Arbeitsgruppe durch das Sputtern nutzt, ist aber gerade der Umstand dass durch die hohe Energie der Ionen beim Sputtern auch größere Bruchstücke herausgelöst werden und so die Stöchiometrie weitestgehend erhalten bleibt (im Gegensatz z.B. zum einfachen Verdampfen). (nicht signierter Beitrag von 77.11.112.198 (Diskussion) 10:31, 6. Jan. 2011 (CET))
- Und wie sieht dein geänderter Vorschlag aus? Da die Form der herausgelösten Teilchen von der Energie abhängt, sollte man auch nicht den Eindruck erwecken, dass beim Sputtern größere Atomcluster freigesetzt werden. Und zumindest beim Reinigungssputtern ist die Vorstellung, dass nur einzelne Atome abgelöst werden, nicht falsch. --Cepheiden 11:26, 6. Jan. 2011 (CET)
Zum "Heraussputtern größerer Bruchstücke" würde ich gerne mal eine Quelle sehen. Bei typischen Ar+ Energien von einigen hundert eV und typischen Bindungsenergien im Targetmaterial von wenigen eV ist der bei weitem wahrscheinlichste Prozeß die Auslösung weniger einzelner Atome. Richtige "Bruchstücke" bekommt man nur durch einen "Dreckeffekt": wenn sich auf der Targetoberfläche scharfe Kanten bilden kann es dort durch Spitzeneffekte zu lokalen Überschlägen kommen (arcing). Das ist dann aber eigentlich Lichtbogenverdampfen (cathodic arc deposition). (nicht signierter Beitrag von 91.2.248.62 (Diskussion) 19:40, 28. Feb. 2011 (CET))
Nachfrage Vakuum[Quelltext bearbeiten]
Es wird nichts darüber erklärt, warum die Technologie im Vakuum angewendet wird. Bitte anfügen. 28.11.2011 --(nicht signierter Beitrag von 62.2.204.182 (Diskussion) 08:19, 28. Nov. 2011 (CET))
- Ich glaube nicht, dass das erklärt werden muss. Wie willst Du was aufsputtern, wenn die Oberfläche binnen Bruchteilen einer Mikrosekunde mit mindestens einer Atomlage "Luft" bedeckt ist? (Hilft Dir das für die Schule?), --He3nry Disk. 08:21, 28. Nov. 2011 (CET)
- Darum geht es weniger, wichtiger ist die mittlere freie Weglänge, damit die Teilchen nicht ständig gestreut werden oder gar mit der Luft reagieren oder sich zu größeren Partikeln zusammen lagern. Hier könnte man durchaus mal ein zwei Sätze zu sagen. --Cepheiden 08:40, 28. Nov. 2011 (CET)
- Also Vakuum ist eigentlich nicht unbedingt noetig, sofern man in seiner Kammer nur Edelgase hat, kann der Druck auch ein wenig hoeher sein. Hab auf einer Konferenz auch mal ein Verfahren gesehen, bei dem absichtlich hoher Druck eingesetzt wurde und das Substrat nicht in Sichtline vom Target war und dann die Atome ueber das Gas transportiert wurden... solange die Technik aber nicht relevant ist kann man den Artikel so lassen. --Do ut des (Diskussion) 14:07, 18. Dez. 2012 (CET)
- Hallo, also was ist denn ein "hoher Druck"? Hier müsste man schon Zahlenwerte angeben oder wenigstens sagen ob er sich im Bereich des Atmosphärendrucks (vgl. Grobvakuum) oder gar darüber bewegt. Bitte solche atypischen Verfahren belegen. --Cepheiden (Diskussion) 15:10, 18. Dez. 2012 (CET)
Aussprache im Deutschen[Quelltext bearbeiten]
Wie wird das i.A. im Deutschen ausgesprochen: eher "deutsch" [ˈʃpuˌtɐn] oder eher "englisch" [ˈspʌˌtɐn]? --Zinnmann d 09:58, 3. Apr. 2017 (CEST)
Inhalte aus Artikel Flabeg[Quelltext bearbeiten]
Das Unternehmen hatte sehr schöne Absätze unter "Aktivitäten" aufgeführt. Ich kopiere die Inhalte hierhin, falls sie noch Verwendung finden können:
"Das Prinzip des Magnetronsputterns basiert auf einer kontinuierlichen Argon-Gasentladung, dem Plasma. Das Plasma wird bei Unterdruck durch eine Hochspannung von bis zu 1000 V gezündet. Das an dem Magnetron befestigte Targetmaterial wird durch den Beschuss mit Argon-Ionen zerstäubt und scheidet sich als dünne, gleichmäßige und kompakte Schicht auf der Glasoberfläche ab. Bei nicht reaktiven Sputterprozessen, wie bspw. von Metallschichten, setzt sich das zerstäubte Kathodenmaterial direkt auf der Glasfläche ab, während es beim reaktiven Sputtern von Oxiden oder Nitriden mit Reaktivgasen vor dem Abscheiden auf der Glasfläche reagiert." "Reaktive und nicht reaktive Sputterprozesse werden in einem einzigen Beschichtungsvorgang aufgebracht. Durch den Einsatz von Doppelmagnetrons lassen sich hochisolierende und hochresistente Siliziumoxidschichten als Basismaterial für optische Funktionsschichten wie bspw. Antireflexsysteme herstellen. Die damit erzielte Entspiegelung beträgt > 99 %."--Zelos2021 (Diskussion) 11:26, 24. Aug. 2022 (CEST)